Globalfoundries setzt auf nächste Lithografie-Generation
Aufgrund der immer kleiner werdenden Fertigungsstrukturen stoßen in naher Zukunft die Maschinen, welche eben erst die Produktion der kleinen Strukturen ermöglichten, an ihre Grenzen. Der aktuellen Immersionslithografie soll deshalb die EUV-Lithografie mit extrem ultravioletter Strahlung folgen.
Globalfoundries bereitet seine im US-Bundesstaat New York gerade im Bau befindliche Fabrik deshalb bereits für den Einsatz der neuen EUV-Lithografie vor. Diese könnte dort ab dem zweiten Halbjahr des Jahres 2012 installiert werden, so dass eine Massenproduktion auf der Grundlage der aktuell noch in der Forschung und Entwicklung befindlichen Technik 2014/2015 beginnen könnte. Die neue Fab 8 (ehemals Fab 2 und auch Fab 4X) soll für die 20/22-nm-Fertigung Anfang 2013 ihren Betrieb aufnehmen.

Globalfoundries würde damit dem bisher vermutetem Zeitplan von einer Einführung frühestens im Jahr 2018/2019 bei einer wahrscheinlichen 11/12-nm-Fertigung gehörig vorgreifen. Die EUV-Lithografie könnte dann nämlich bereits bei 16 nm eingesetzt werden. Da sich in der Vergangenheit die Zeitpläne aber bereits massiv verschoben hatten, bleibt fraglich, ob die sehr optimistischen Angaben auch Bestand haben werden. So wurde beispielsweise 2004 angekündigt, dass man bereits im Jahr 2009 die EUV-Lithografie in der Massenfertigung einsetzen will – davon sind wir aber selbst 2011 noch sehr weit entfernt.
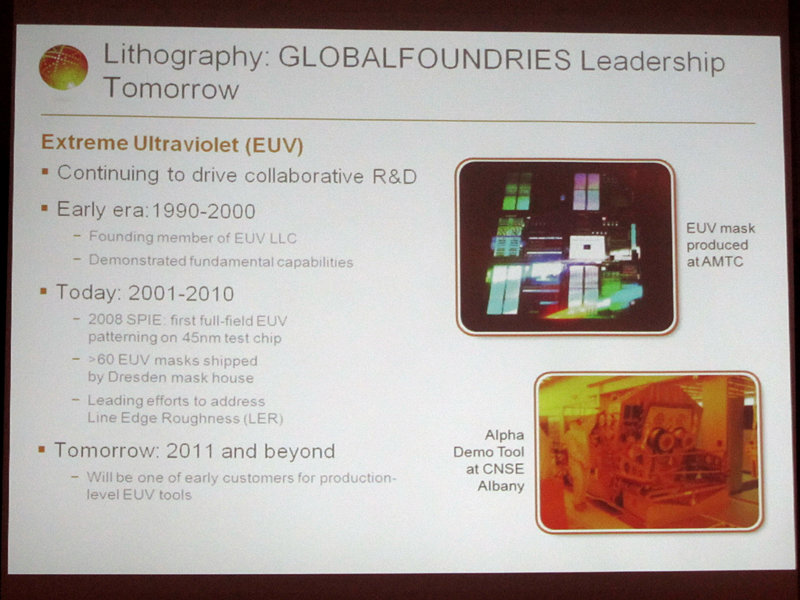
Im Jahr 2008 hatte AMD zusammen mit dem großen Partner IBM die erste vollständige Belichtung eines Wafers mit der EUV-Lithografie und realen Chips in 45-nm-Technologie vermeldet. Seitdem seien mehr als 60 verschiedene Masken für die weitere Forschung und Entwicklung der Technik in Dresden produziert worden. Auch TSMC ist in dieser Richtung nicht untätig und hat bereits vor einem Jahr entsprechende Ausrüstung von ASML bezogen. Die größte Herausforderung besteht dabei unter anderem in der massiven Änderung der Wellenlänge der Belichtungsquelle, die sich von 193 nm bei der Immersionslithografie auf 13,5 nm bei der ultravioletten Lösung verringert, und der für die Bereitstellung benötigten Aufbauten.
Im Podcast erinnern sich Frank, Steffen und Jan daran, wie im Jahr 1999 alles begann.
