Samsung: 64-GB-DDR4-Module mit 3D TSV in Serienproduktion
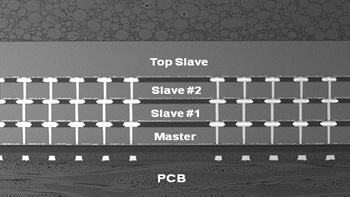
Vom Übereinanderstapeln mehrerer DRAM-Dies, die mittels Silizium-Durchkontaktierung miteinander verbunden werden, verspricht sich die Branche höhere Speicherdichten, mehr Leistung und weniger Energiebedarf. Samsung beginnt nun mit der Massenfertigung erster 64-GB-DDR4-Module mit „3D-TSV-Technik“.
TSV steht für Through-Silicon Via, wobei es sich um eine elektrische Verbindung durch Silizium-Schichten hindurch handelt, weshalb im Deutschen von Silizium-Durchkontaktierung gesprochen wird. In Form vertikaler Verbindungen ermöglicht die Technik Speicherchips mit mehreren übereinander gestapelten DRAM-Dies.

Samsungs neue DDR4-RDIMMs für den Server-Einsatz besitzen 36 Chips, die sich jeweils aus vier DRAM-Dies à 4 Gigabit zusammensetzen. Gefertigt werden die Dies in einem Prozess der „20-nm-Klasse“. Anders als bei Samsungs V-NAND, bei dem die Zellschichten in einem monolithischen Die gefertigt sind, handelt es sich bei „3D TSV“ um eine Packaging-Technik: Die planaren DRAM-Dies werden erst nachträglich übereinandergestapelt und mittels TSV miteinander verbunden. Der Hersteller beschreibt das Verfahren wie folgt:
Bei der Herstellung eines 3D TSV DRAM-Packages werden DDR4-Dies mit wenigen Dutzend Mikrometer Stärke übereinander gestapelt und gezielt durchlöchert, um hunderte winzige Löcher zu erhalten. Die Dies werden über Elektroden, die durch die Löcher gesteckt werden, vertikal miteinander verbunden. Daraus resultierend sind die neuen 64GB TSV-Module doppelt so schnell wie 64GB-Module, die Packaging mit Drähten (Wire Bonding) nutzen. Außerdem verbrauchen die neuen Module nur halb so viel Energie.
Samsung
Laut Samsung handelt es sich um die industrieweit ersten 64-GB-DDR4-RDIMMs mit TSV, mit deren Massenproduktion nun begonnen wurde. Der DRAM-Marktführer geht davon aus, dass die eigene 3D-TSV-Technik auch das Stapeln von mehr als vier DDR4-Dies erlaubt, wodurch eine nochmals höhere Speicherdichte erreicht werden könnte.
Schon 2010 präsentierte Samsung erste RDIMMs mit Stapelspeicher. Auch bei anderen Herstellern wie SK Hynix und Auftragsfertiger Globalfoundries wird die Technik genutzt. Microns Hybrid Memory Cube (HMC) nutzt ebenfalls TSV und verspricht dabei vor allem hohe Datenraten bei deutlich geringerem Energiebedarf.