Intel „Broadwell“ im Detail: Loch im Mainboard für Core M
2/5Turbo & Power-Management
Eine der größten Optimierungen von „Broadwell-Y“ als Low-Power-Design betrifft das Power Managements, zu dem auch der Turbo der CPU zählt. So wurde die Leistungsaufnahme im Leerlauf noch weiter optimiert, parallel dazu aber auch in allen weiteren Lagen, in denen sich der Prozessor samt Grafik bewegen kann. Dabei greifen die Optimierungen nicht nur an der Spannung, auch die Frequenz der einzelnen Bereiche wurde je nach Bedarf angepasst.

Auch beim Turbo für CPU-Kerne und Grafikeinheit hat Intel noch einmal Hand angelegt, um diesen nicht nur auf reine Leistung, sondern auch auf Effizienz zu trimmen.
Für den Leerlauf will Intel so eine 60 Prozent niedrigere Leistungsaufnahme erzielen und die Batterielaufzeit von Notebooks damit erhöhen.
Der neue Chipsatz (PCH)
Eine neue Plattform ist in zuvor noch nie genutzter 14-nm-Fertigung bei der CPU nur so gut wie ihr schwächstes Glied: der Chipsatz. Insbesondere dann, wenn er aufgrund des Multi-Chip-Packages auf dem gleichen Trägermaterial sitzt. Bei Broadwell setzt der Chipsatz auch weiterhin auf 32 nm, trotzdem verspricht Intel signifikante Verbesserungen bei der Energieeffizienz gegenüber dem Vorgänger. Im Leerlauf soll der Chip ein Viertel weniger Strom verbrauchen als bei Haswell, unter Last sollen durch zusätzliche Betriebszustände noch zwanzig Prozent drin sein.

Neben dem Fokus auf eine niedrige Leistungsaufnahme in allen Bereichen wurden auch die gebotenen Anschlüsse aktualisiert. Massenspeicher kann direkt über PCI Express angebunden werden, am integrierten Audio DSP wurde gefeilt.
Ein „Loch“ im Mainboard
Während der Fokus der Betrachtungen seit einigen Monaten auf dem kleinen „Broadwell“-Chip für den verlötbaren BGA-Sockel vornehmlich in der Fläche liegt, ist die eigentliche Besonderheit die Höhe. Denn Intel hat die Gesamthöhe um 30 Prozent von 1,50 auf 1,04 mm reduziert, die dritte Dimension des sogenannten Package Core wurde gar von 400 Mikrometer bei „Haswell-ULT/Y“ auf 200 µm halbiert.
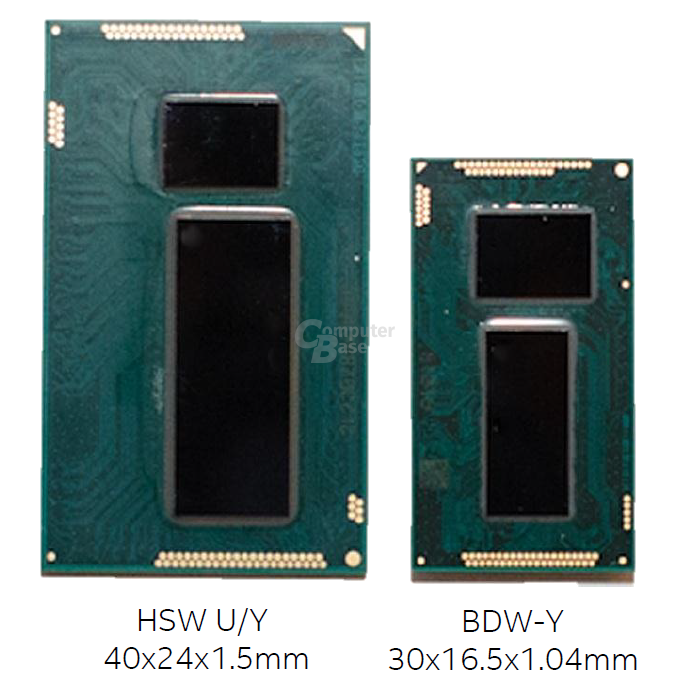
Bisher sieht das klassische BGA-Modell oftmals die Nutzung der gesamten Unterseite eines Chips für die Verlötung mit dem Mainboard vor, sodass dieser nahezu plan aufliegt. Hier und da gibt es Ausnahmen, beispielsweise wenn die Chips größer sind, jedoch weniger Kontakte zum Mainboard nötig werden. Dann bleiben insbesondere in der Mitte freie Stellen oder der Abstand zwischen den Lötstellen wird vergrößert. Intel nutzt für „Broadwell-Y“ einen von 0,65 auf 0,50 mm verkleinerten Abstand zwischen den Lötstellen und packt, wie von sockelbaren Lösungen bekannt, Spulen und Kondensatoren, die vornehmlich der Stromversorgung dienen, auf die Unterseite. Dieses „3DL“ getaufte Modul benötigt allerdings seinen Platz: Ein Loch im Mainboard muss her.

Die Spezifikationen für die „Broadwell-Y“-CPUs sehen vor, dass die Chips selbst auf günstigen 6-Layer-Mainboards problemlos Luft nach unten haben werden, wenn sie mit der Platine verlötet werden.
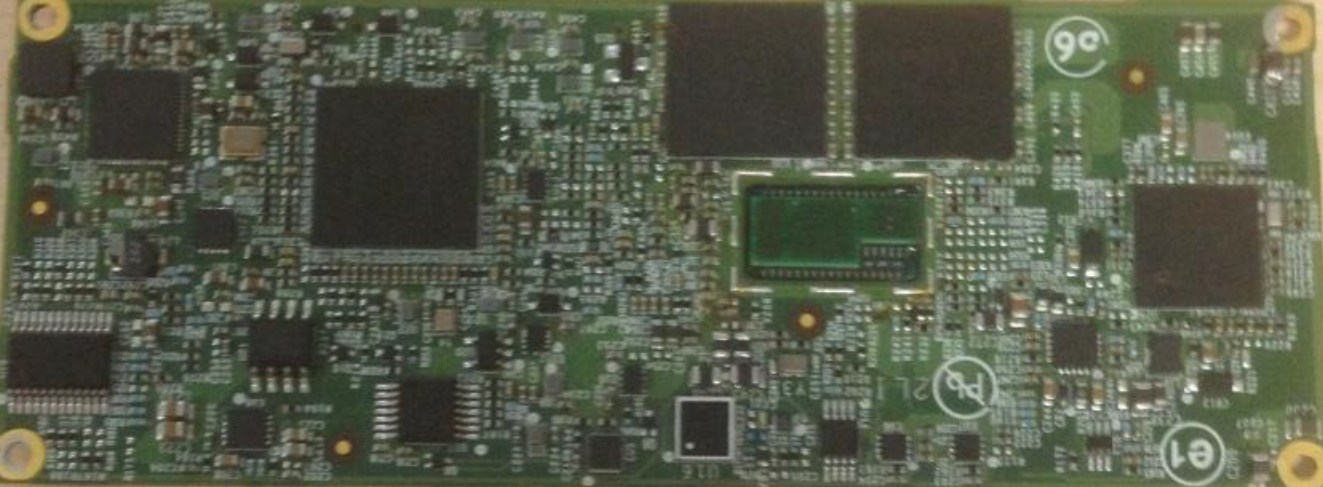
Apropos Größe: Anhand des Multiplikators von 0,63 lässt sich die Die-Größe von „Broadwell-Y“ gegenüber Haswell bestimmen. Während der „Haswell-ULT/Y“-Die noch 130 mm² groß war, wird der erste Core M mit einer Die-Fläche von nur noch 82 mm² für das Dual-Core-Design inklusive gleicher L3-Cache-Menge wie der Vorgänger jedoch mit noch größerer Grafikeinheit ins Rennen gehen.